

Производитель — PANalitical, Нидерланды, 2006 год.
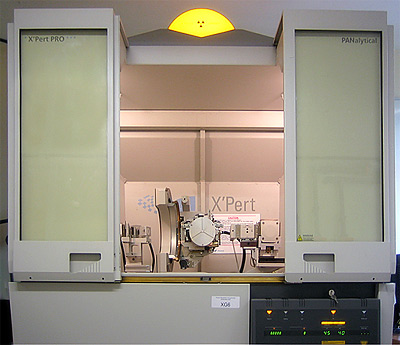
 |
Схема установки. |
 |
Схема движений, обеспечиваемых гониометром. |
Установка позволяет производить исследования кристаллических материалов и искусственных многослойных систем методом дифракции рентгеновских лучей, в том числе — малоугловой. Источником рентгеновского излучения с длиной волны Cu Kα 0,154 нм служит рентгеновская трубка (напряжение 60 кВ, ток 60 мА). Спектральная и угловая монохроматизация зондового пучка осуществляется с помощью четырехкристального асимметричного монохроматора Ge (220). Образец устанавливается на стол с 6-ю степенями свободы, что позволяет изучать локально по всей поверхности как плоские, так и изогнутые образцы. (Коллиматор Соллера, ограничивающий вертикальную расходимость, установлен за щелями детектора и на рисунке не показан).
|
Диапазон |
Точность |
|
|
Горизонтальная расходимость пучка, º |
< 0,0053 |
|
|
Вертикальная расходимость пучка, º |
- |
|
|
Горизонтальная раходимость регистрируемого пучка, º |
0,008-0,54 |
|
|
Вертикальная расходимость регистрируемого пучка, º |
1,15 |
|
|
Угловое сканирование образца Θ, º |
-4,75º - +81,50º |
лучше 0,001 |
|
Угловое сканирование детектора 2Θ, º |
-9,50º - +163,0º |
лучше 0,001 |
|
Вращение образца Ф, º |
360 |
0,01 |
|
Наклон образца Ψ, º |
180 (±90) |
0,01 |
|
Сканирование по X, мм |
100 |
0,01 |
|
Сканирование по Y, мм |
100 |
0,01 |
|
Сканирование по Z, мм |
11 |
0,001 |
|
Максимальный размер образца, мм |
100×100×24 (без съема держателя) |
|
|
Максимальный вес образца, кг |
0,5 |
Комплексы Philips X'Pert в основном используются для изучения малоуглового рассеяния жесткого рентгеновского излучения. Этот метод является одним из наиболее развитых и востребованных на практике способов неразрушающего контроля внутреннего строения кристаллов и поликристаллических веществ, многослойных структур, микрошероховатости поверхностей и др. физических объектов. Малая длина волны, сравнимая с межатомными расстояниями, обуславливает чувствительность метода к атомному строению материалов. Несмотря на низкую рассеивающую способность атомами излучения в этом спектральном диапазоне, интерференция рентгеновских лучей в большинстве случаев приводит к резонансному увеличению интенсивности рассеянного (отраженного) излучения, тем самым, обеспечивая исследователей надежной информацией о структурных и иных свойствах изучаемых объектов. Кроме того, из-за низкого поглощения и рассеяния излучения в воздухе, большинство экспериментов проводится на воздухе (без использования вакуумного оборудования), что существенно уменьшает время подготовки и проведения эксперимента.
Прибор позволяет получать кривые зеркального отражения и диффузного рассеяния рентгеновского излучения и может быть применен для следующих видов анализа: