

Масс-спектрометр вторичных ионов TOF. SIMS 5 для элементного анализа по глубине и по площади образца (производитель IONTOF, Германия, 2008 г).
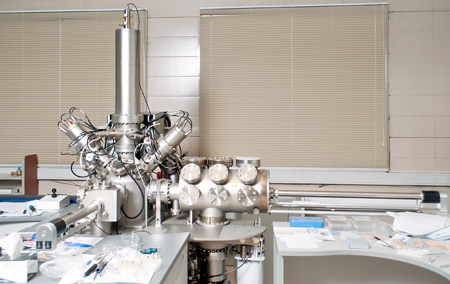

Система формирования первичных зондирующих ионов Bi и вторичных регистрируемых ионов.
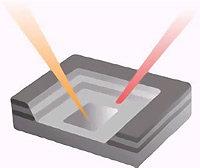
TOF.SIMS-5 — ВИМС нового поколения — использует новый принцип двух ионных пучков — синхронное чередование импульсных анализирующего и распыляющего пучков. Анализирующий пучок ионов (Bi) является практически неразрушающим, поэтому в установке TOF. SIMS-5 впервые реализован принципиально новый режим послойного анализа, сочетающий статический и динамический режимы ВИМС. Это дает уникальную возможность анализа ультратонких структур с толщиной от 1нм до 10нм, поскольку отсутствуют эффекты формирования переходных областей, характерные для динамического режима ВИМС. В то же время, использование коротких анализирующих импульсов позволило существенно снизить длину пролетной области анализатора при сохранении высокого (10000) массового разрешения и значительно повысить частоту повторения импульсов до 50кГц. Поэтому в установке TOF. SIMS-5 достигнута очень высокая скважность распыляющего ионного пучка и высокая скорость распыления по сравнению с предыдущими моделями -TOF.SIMS-3 и 4, что дает возможность проведения послойного анализа до глубины 10мкм, фактически предельной для задач ВИМС.
Возможность вариации типа и массы анализирующих ионов позволяет минимизировать матричные эффекты при послойном анализе металлических структур. Кроме того, для кластерных вторичных ионов глубина выхода, как правило, ниже 0.5нм.
Принципиально новые возможности представляет TOF. SIMS-5 для анализа диэлектрических структур, а также тонкопленочных плохо проводящих структур на диэлектрических подложках, что часто составляет неразрешимую проблему в установках динамического ВИМС. Для этого в установке размещена дополнительная низкоэнергетическая электронная пушка, которая также имеет импульсный режим работы. Электронный пучок позволяет полностью нейтрализовать заряд, вызванный анализирующим пучком ионов с низкой величиной тока. Для компенсации заряда, вызванного распыляющими ионными пучками со значительно большей величиной тока (сотни нА), предусмотрено введение дополнительных временных задержек в последовательности «распыление-анализ» в очень широком диапазоне от единиц микросекунд до нескольких секунд.

Две низкоэнергетические распыляющие ионные пушки с ионами кислорода O и Cs с энергией пучка от 250эВ до 2кэВ c возможностью варьирования угла падения ионного пучка на поверхность в широких пределах. Имеется дополнительная возможность подачи газообразного кислорода на поверхность анализируемой структуры в условиях сверхвысокого вакуума, что может позволить избежать развития шероховатости в области кратера и повысить чувствительность для ряда элементов.
Для анализа используется жидко-металлическая ионная пушка с ионами Bi с очень низкой величиной тока (1пА, 25кэВ) и короткими импульсами (короче 1нс, до 50 кГц).
Время-пролетного типа с импульсным режимом работы.
Имеется возможность вариации типа и массы анализирующих ионов — Bi<+>, Bi<++>, Bi<3>, Bi<5>, что обеспечивает высокую чувствительность и дает новую возможность анализа вторичных кластерных ионов даже самых тяжелых элементов в очень широком диапазоне масс (1 — 10000 а. е. м.).
 Метод ВИМС позволяет получать следующую информацию о составе структур:
Метод ВИМС позволяет получать следующую информацию о составе структур: