Дифрактометр рентгеновский Bruker D8 Discover
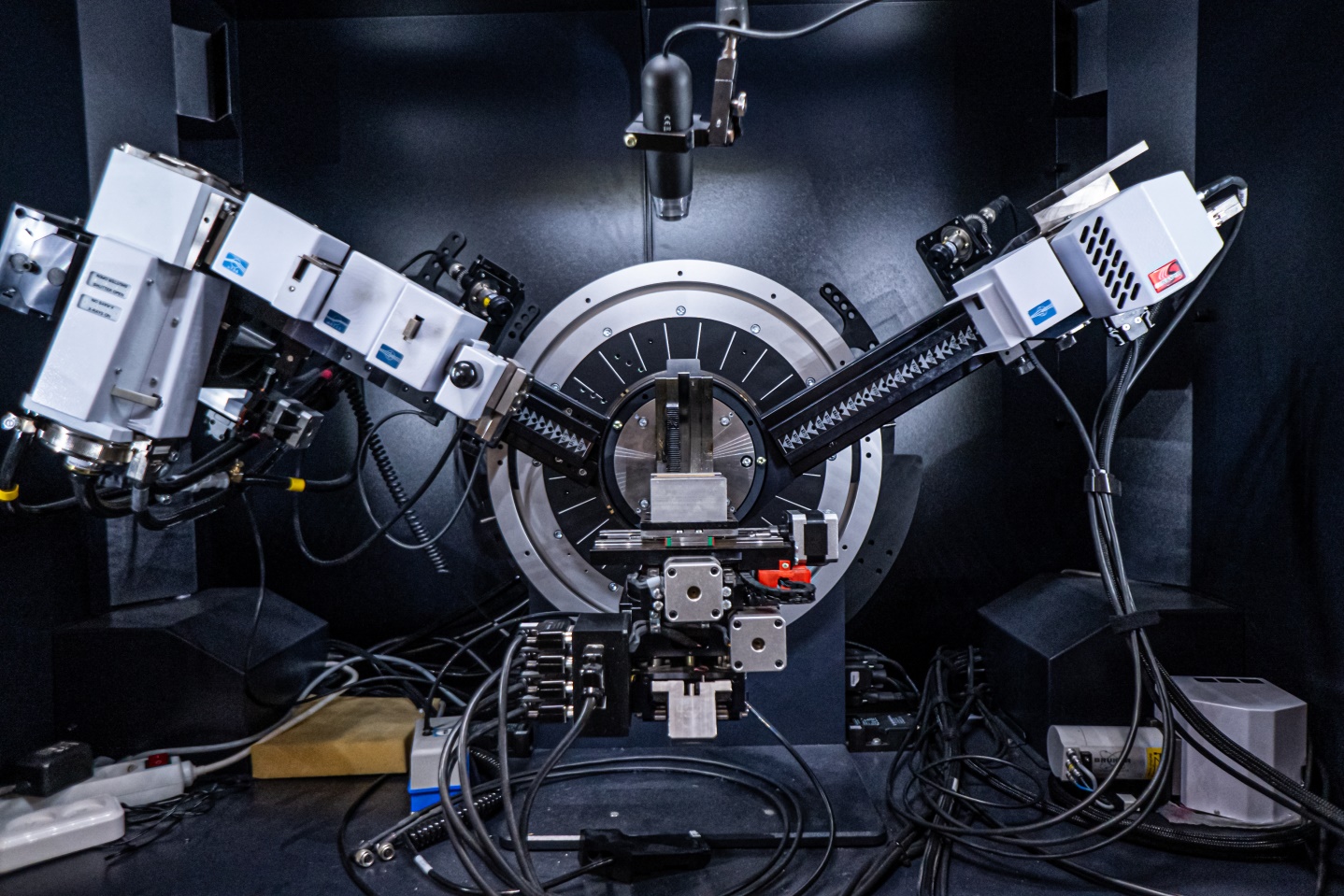
Контактное лицо
Описание установки
Производитель - Bruker, Германия, 2011 г.
Прибор имеет вертикальный гониометр θ/θ-геометрии с позициями для крепления рентгеновской трубки (CuKα излучение, поворотный линейный/точечный фокус), оптики первичного пучка (многослойное зеркало Гёбеля/поликапиллярная полулинза Кумахова, монохроматоры двукратного и четырехкратного отражения Ge(220) для схем «среднего» и «высокого» разрешения, щели и коллиматоры пучка), оптики отраженного пучка (переменная щель/щель Соллера/кристалл-анализатор) и детектора (точечный сцинтилляционный/линейный детектор LynxEye). Держатель образца – эйлерова подвеска с поворотами по осям φ и ψ, подвижками по XYZ. Конфигурация позволяет выполнять качественный и количественный анализ поликристаллов с высокой чувствительностью к побочным фазам, текстурный анализ образцов с построением полюсных фигур, ориентировку (в том числе и прецизионную с точностью ~ 1’) монокристаллов, малоугловую рефлектометрию тонких пленок и многослойных покрытий, высокоразрешающую рентгеновскую дифрактометрию.Услуги
- Определение отклонения среза кристаллических подложек на дифрактометре Bruker D8 Discover
- Рентгеновский дифракционный анализ эпитаксиальных слоев на дифрактометре Bruker D8 Discover
- Рентгеновский дифракционный анализ поликристаллических образцов на дифрактометре Bruker D8 Discover
- Анализ тонких слоев методом рентгеновской рефлектометрии на дифрактометре Bruker D8 Discover
Результаты
- Прецизионная ориентировка монокристаллических подложек HPHT алмаза
- Текстурный анализ медных облицовок, изготовленных методом сферодвижной штамповки
- Фазовый анализ поликристаллических тонких пленок
- Качественный и количественный фазовый анализ для исследования химической кинетики в системе YAG-YAM-YAP
- GIXRD анализ керамик и тонких пленок
- Определение параметров многослойных тонкопленочных SFS структур методом малоугловой рефлектометрии
- Определение параметров структур кремний-на-изоляторе методами рентгеновской рефлектометрии и дифрактометрии
- Исследование транзисторных структур на основе AlGaN методами высокоразрешающей рентгеновской дифрактометрии, картирования обратного пространства и малоугловой рефлектометрии
- Определение параметров квантовых ям InGaAs в структурах HEMT транзисторов на основе A3B5
- Определение параметров структур квантово-каскадных лазеров методом высокоразрешающий рентгеновской дифрактометрии
- Исследование ограничений метода рентгеновской дифрактометрии при анализе вхождения атомов теллура в эпитаксиальные слои GaAs
Технические характеристики
Гониометр и подвеска образца
Минимальный шаг по углам Theta и 2Theta: 0,0001°.
Воспроизводимость установки углов Theta и 2Theta не хуже 0,0001°.
Подвеска образца имеет моторизированные оси ψ, φ, X, Y, Z.
Поворот по углу ψ в интервале от -3° до +93°.
Поворот по углу φ: 360°.
Вакуумный вращающийся держатель образцов диаметром 125 мм.
Сменная рентгеновская оптика на первичном пучке
Система крепления рентгеновской трубки позволяет выполнять переход от линейной к точечной проекции фокуса
POLYCAP- параллельно-лучевая капиллярная полулинза (поликапиллярная полулинза Кумахова) для точечного фокуса трубки, диаметр круглого параллельного пучка на выходе 6 мм.
Параболическое многослойное рентгеновское зеркало (зеркало Гёбеля) для CuKα-излучения и линейного фокуса трубки.
Блок-монохроматор с 4-х кратным отражением Ge(220), совместимый с зеркалом Гёбеля, для линии CuKα1. Расходимость на выходе ~12’’.
Прорезной монохроматор 2-х кратного отражения (бездисперсионная схема, «среднее разрешение», расходимость ~ 40’’), совместимый с зеркалом Гёбеля.
Сменная рентгеновская оптика на отраженном пучке
Прорезной кристалл-анализатор с 3-х кратным отражением Ge (220).
Щель Соллера с угловым разрешением 0,05°.
Программируемая щель переменного размера.
Детекторы
Позиционно-чувствительный линейный детектор с числом каналов 192 (апертура 2° по углу 2θ) для анализа поликристаллов и текстур.
Точечный сцинтилляционный детектор с системой PATHFINDER для высокоразрешающей дифрактометрии: переменная щель/щель Соллера/кристалл-анализатор 3хGe(220).
Программное обеспечение
программы управления и планирования эксперимента;
анализ эпитаксиальных структур по дифрактограммам высокого разрешения, моделирования с помощью динамической теории дифракции с использованием баз данных материалов;
анализ покрытий и поверхностных слоев по данным малоугловой рефлектометрии;
построение и анализ прямых и обратных полюсных фигур, функции распределения ориентаций для анализа текстур;
Анализ остаточных напряжений в поликристаллических и монокристаллических материалах;
качественный и полуколичественный рентгенофазовый анализ с использованием базы порошковых данных PDF2;
Полнопрофильный анализ методом Ритвельда
Прибор обеспечивает возможность исследования следующих видов материалов:
эпитаксиальные многослойные структуры;
монокристаллы;
текстурированные материалы;
поликристаллические материалы и порошки;
Аморфные и поликристаллические покрытия и приповерхностные слои.
Реализованы следующие схемы проведения эксперимента:
θ/2θ съемка дифрактограммы поликристалла;
2θ/ω-сканирование с высоким разрешением, со средним разрешением и высокой чувствительностью;
построение прямой полюсной фигуры;
ХУ-картирование исследуемых параметров образца по площади;
GIXRD-анализ в геометрии скользящего падения (2θ-сканирование при постоянном угле падения).
съемка кривой малоугловой рефлектометрии.
построение двумерных карт обратного пространства.
