Вакуумная установка резистивного и электронно-лучевого испарения с холловским ионным источником Amod 206
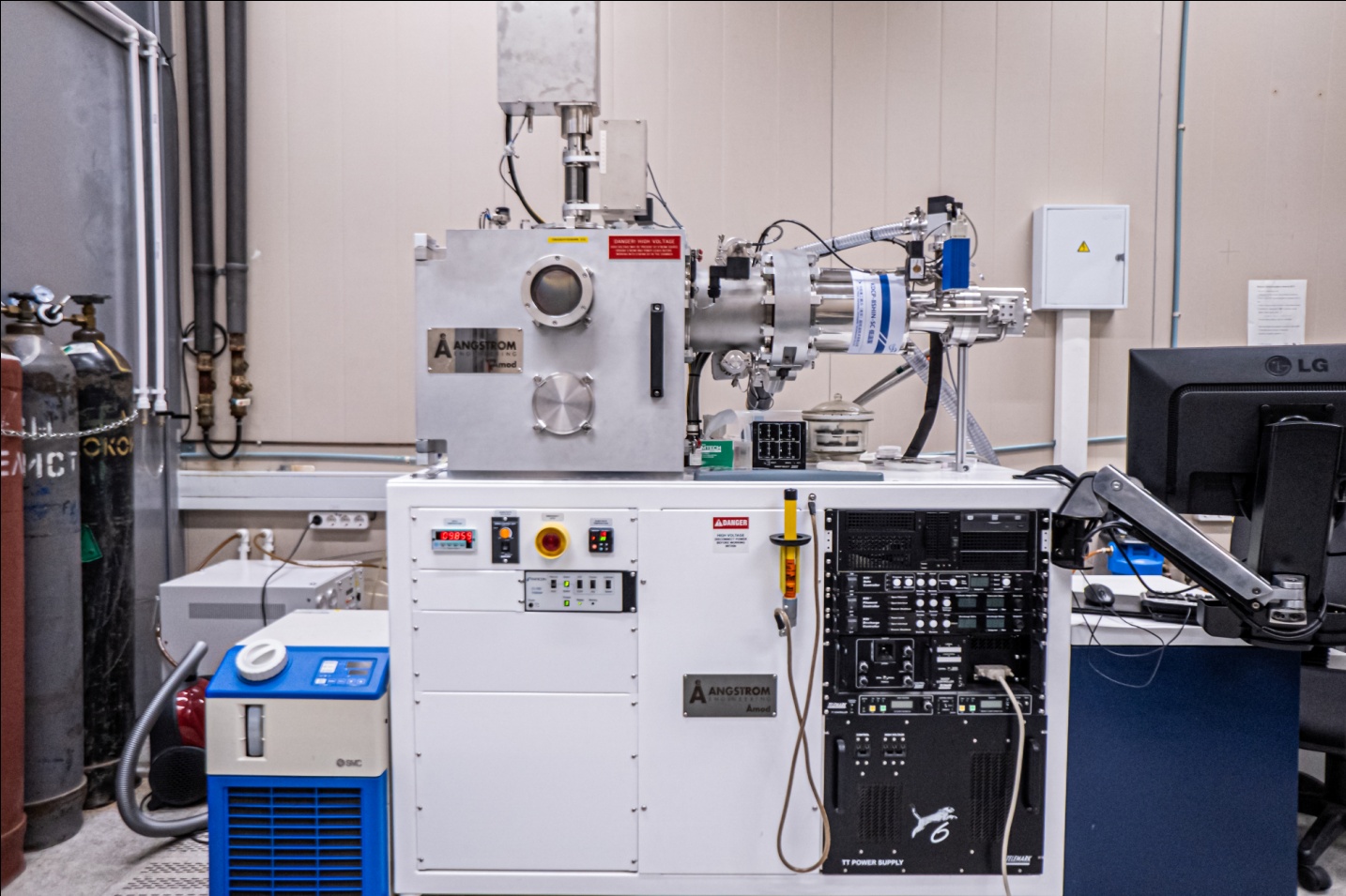
Контактное лицо
Описание установки
Для чистоты и качества напыляемых пленок в установке предусмотрена вакуумная система, обеспечивающая высокий вакуум до 10-8 Торр.Камера оснащена электронно-лучевым и резистивным испарителями, что позволяет распылять широкий спектр материалов.
С помощью ионного источника может проводиться травление поверхности на небольшую глубину (в кислороде, азоте и др. газах) или очистка подложки для улучшения адгезии (обычно в аргоне) перед процессом напыления пленки без разрыва вакуума.
Имеется возможность нагрева подложки до 600°С, а также возможность многослойного напыления из разных материалов в одном технологическом процессе без нарушения вакуума. В процессе напыления осуществляется точный контроль скорости и толщины пленки (до 0.1 нм) с помощью кварцевого резонатора.
Установка позволяет воспроизводимо получать высококачественные тонкие пленки и многослойные наноструктуры в условиях чистого высокого вакуума.
Результаты
Технические характеристики
- Рабочая камера из нержавеющей стали со смотровым окном
- Вращающийся столик – подложкодержатель с возможностью охлаждения, диаметром 150 мм
- Источник электронно-лучевого испарения оснащен шестью тиглями для соосаждения разных материалов в одном процессе
- Нагреватель с обратной стороны подложки на основе кварцевой лампы (IR нагрев). Температурный контроль нагрева подложки от комнатной температуры до 600°C.
Программное обеспечение
- Система управления установкой SCADA на базе Windows
- Автоматический и ручной режим управления системой
Установка обеспечивает возможность напыления следующих материалов:
- Диэлектрики
- Полупроводники
- Металлы
